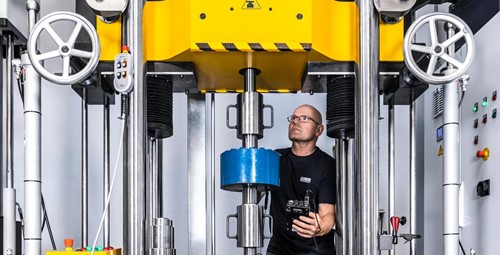
Tryk- og kraftlaboratoriet
Kraftlaboratoriet består af Danmarks største fuldautomatiske kraftmaskine og er 5 gange mere nøjagtig end lignende kraftkalibreringsudstyr på det danske marked.

Mekanisk testudstyr
FORCE Technology har investeret i en lang række mekaniske testfaciliteter til udførelse af tests i henhold til de fleste produktstandarder og generiske standarder.

Tribologi - friktion, mekanisk slid og smøring
Teknologisk Institut har faciliteter, hvor der kan arbejdes med belægninger til de fleste former for produktionsværktøjer, maskindele og færdige komponenter.

Metallurgi og Prøvning
Teknologisk Instituts materialeteknologiske laboratorier og udstyr kombineret med vores brede ekspertise inden for metalliske materialer udgør en unik platform for at sammensætte de løsninger, som skal styrke den danske industri.

Design af produktionsanlæg på slagterier
Baseret på vores eget forskningsarbejde designer Teknologisk Institut produktionsanlæg, primært til kødindustrien.

Lugtlaboratoriet
Lugtlaboratoriet er akkrediteret til prøvetagning, måling og analyse af lugtemissioner fra industri, anlæg, restaurationer og andre virksomheder, der udleder lugt.